
2024 GTC 大会上,黄仁勋右手 B200,左手 H100,理所当然地有了新人忘旧人:「我们需要更大的 GPU,如果不能更大,就把更多 GPU 组合在一起,变成更大的虚拟 GPU。」
英伟达公布的 Blackwell 架构的 B200 GPU,亲手把网红显卡 H100 拍在了沙滩上。按照黄仁勋的介绍,B200 理论上的 AI 性能可达 20PFLOPS,是 H100 的五倍。相比 H100 的 800 亿晶体管规模,B200 的晶体管规模高达 2080 亿。一般来说,芯片算力提升的最常用方法是采用先进制程,用更高的密度在芯片里塞进更多晶体管。如摩尔定律所说:集成电路上可以容纳的晶体管数目,大约每经过 18 个月到 24 个月便会增加一倍。比如采用 7nm 工艺的 A100 GPU,芯片(Die)面积为 826mm² ,内有 542 亿晶体管;采用 5nm(台积电 N4)工艺的 H100,芯片面积缩小为 814mm² ,晶体管数量反而暴涨至 800 亿。然而,B200 在晶体管数量提高近三倍的同时,并没有用更先进的 3nm 工艺,而是采用了和 H100 一样的 5nm 工艺。黄仁勋所说的「大」和「组合」,是字面意义上的:
从技术原理看,B200 其实是把两块芯片「拼」成了一个大芯片。在英伟达的 PPT 演示里,两颗 GPU 从边缘「无缝粘合」在一起,面积 X2 的同时,算力翻倍。1+1=2 的方法看似简单粗暴,背后却是一场在物理学边缘的冲锋与冒险。1+1 有时候不等于 2
工厂提高生产力有两种办法:一是扩建厂房,装进更多的生产线;二是升级生产线,在厂房面积不变的情况下,增加生产线数量。芯片公司一直以来都在采用第二种方法:通过生产线创新(工艺制程),在有限的芯片面积里塞进更多晶体管,避免扩建厂房带来的房租成本上涨。但这种方式的局限性在于,生产线创新(工艺制程)对应的研发成本越来越高,甚至有高过房租的趋势。H100 采用的 5nm工艺,很可能就是 GPU 量产的极限制程,继续下探到 3nm,很可能成本上吃亏。扩建厂房的确是一个办法,但放在芯片生产上,会遇到一个中国人很熟悉的问题:土地供应有限。每一颗芯片都是从 12 寸的硅晶圆(土地)上「切」下来的,那么芯片(厂房)面积越大,每块晶圆能「切」出来的芯片就越少。再考虑到良率和大面积芯片的散热问题(施工事故),单个芯片成本会成倍提高。由此衍生出了第三种思路:建一个一模一样的厂房,让两个厂房同时生产,既避开了成本问题,又提高了生产效率。芯片在执行计算任务时需要经历两个阶段:数据传输和计算,数据传输花费时间过多,计算「空载」,就会造成算力的浪费。就像两间厂房需要一个工头传达指示,工头在 A 厂房发表讲话时,B 厂房的工人都在摸鱼。这就导致在一块主板上封装 10 颗芯片,性能非但不会提高 10 倍,反而很可能连两倍都不到。2011 年,英伟达发布了 GTX590 显卡,最大特点是在一个 PCB 板上装了两颗 GPU 芯片。但在具体的游戏中,想同时调用两颗 GPU 的算力,不仅需要专门的软件支持,性能也只有单颗芯片的 130% 左右。 GTX 590 显卡里有两颗 GPU 芯片
GTX 590 显卡里有两颗 GPU 芯片
为了解决产线工人趁着工头不在消极怠工的问题,英伟达团队在 2017 年发表论文,提出了名为「可组合封装 GPU」的架构,核心在于将多颗 GPU 集成在同一个芯片封装内。传统的芯片封装是「先封再拼」,即两颗芯片封装完毕,再用导线连接。英伟达的方案是「先拼再封」,先把两颗芯片拼成一个大芯片,再封装到一起。把芯片(厂房)之间的物理距离缩减到 0,工头传递指示,两边的工人同时学习贯彻,降低数据传输时间,实现 1+1=2。几个月后,老对手 AMD 表示论文谁不会写,刊发论文展示了 4 颗 GPU 集成在同一封装内的设计,宣称其性能比当时的最强 GPU 还要高 45.5%,并且 coming soon。但无论是英伟达还是 AMD,都没能把这个方案真正「soon」出来。苹果的超能力就是有钱
2022 年,苹果发布了 M1 Ultra 芯片,其最大特点是直接将两颗 M1 Max 芯片「粘合」在一起,变成一张大芯片,业内戏称「胶水大法」。M1 Ultra 在工作时依然表现出一枚芯片的整体性,也会被所有软件识别为一枚完整芯片,开发者无需重写代码就能直接运用它的强大性能。这在史上从无先例。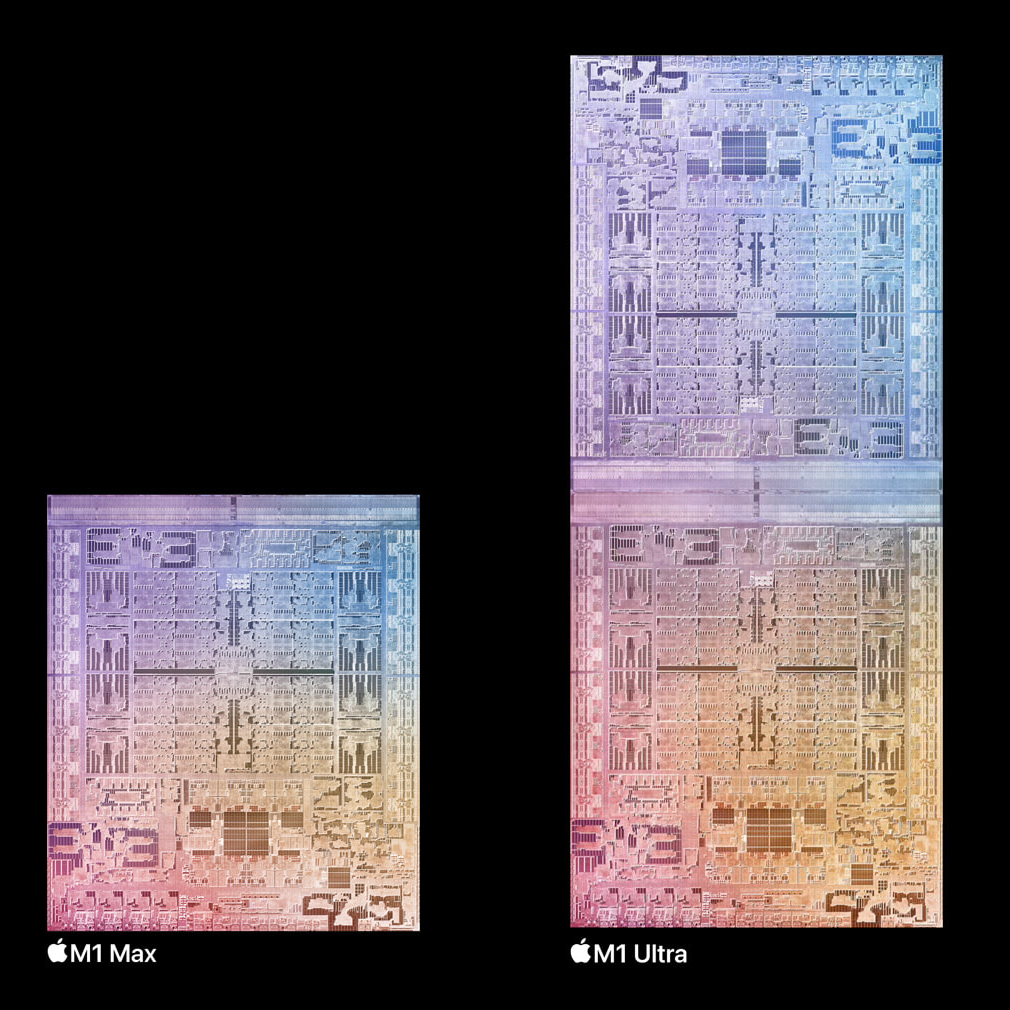 M1 Ultra 由两颗一模一样的 M1 Max 芯片拼接而成
M1 Ultra 由两颗一模一样的 M1 Max 芯片拼接而成
苹果之前,几乎所有的「缝合」方案,都无法解决芯片在连接过程中产生的损耗,使得性能往往「1+1<2」。M1 Ultra 的背后,是一个名为 Ultra Fusion 的「缝合技术」。按照苹果官方的说法,Ultra Fusion 由苹果与台积电共同研发。但从经验看,苹果发挥的最大作用,是以「技术冠名费」的方式,报销了台积电的研发开支。两颗芯片的缝合,核心是要解决芯片间的数据传输问题。为了实现「无缝粘合」,苹果用上了台积电最昂贵、最先进的封装技术——第五代 CoWoS-S。传统的传输方式是将两颗芯片封装在一块基板上,芯片之间的传输由引线解决。CoWoS 方案在基板和芯片之间加了一层硅中介层,通过在硅中介层里布线,间接将两颗小芯片连接起来,连接密度是现有技术的两倍。硅中阶层本质上是一片硅晶圆,也就是「切」芯片的原材料。仅仅为了做连接,就要另加一层硅晶圆的费用,这手笔恐怕只有苹果做得出来。后来,英伟达在 H100 上采用了更成熟的 CoWoS,成本仍超过 4000 美元。苹果作为最初的试错者,成本只会更高。除了 CoWoS,苹果的钱还烧在了「缝合」技术上。芯片制造的本质,是在硅晶圆上刻画复杂电路。但在实际制造过程中,电路不是直接刻在硅晶圆上的,而是先刻在一个掩膜版上,再通过光刻和刻蚀把电路「转移」到硅晶圆上。英伟达当年遇到的问题是,GPU 芯片本身面积就大,一旦两颗 GPU 拼接,就会超过正常掩膜版的大小(H100 的面积已经接近台积电 5nm 掩模版的极限),电路就无法被完整地刻画。苹果提出的解决方案是,1 个掩膜版不够,咱直接上四个吧。通过四个掩膜版「缝合」,将电路刻画的面积增加到 2500mm² ,是英伟达同期 GPU 的 3 倍多(815mm² )。掩膜版生产需要 Mask Writer(掩膜版写入机),精密程度堪比光刻机。而且 Mask Writer 只在掩膜版制作时使用,每种芯片只做一次,难以摊薄成本。除此之外,由于 Ultra Fusion 用到了大量新技术,比如连接芯片的高纵横比硅通孔(TSV)技术,用于散热的新型非凝胶型热界面材料(TIM)等,台积电都是拿着发票找苹果报销的。M1 Ultra 发布时,业界都没有准确的成本推算。不是研究员水平不到位,实在是技术过于先进,算不出来。高科技产业最关键的问题不是技术如何实现,而是谁来掏钱把论文和实验室里的数据变成可以量产的产品。不知道看着 M1 Ultra 的拼接示意图,会不会有久远的记忆攻击黄仁勋。技术狂人的商业冒险
最早试图解决的 1+1<2 问题的,既不是英伟达也不是苹果,而是台积电元老蒋尚义。2009 年,回归台积电的张忠谋请回已经退休的蒋尚义。在后者带领下,台积电以「后闸级」技术路线成功超越三星率先量产 28nm 工艺。但在研发过程中,蒋尚义发现晶体管单位制造成本不降反升,制程升级提升性能的性价比开始降低。拿着张忠谋批的 1 亿美元预算和 400 多人的工程师团队,蒋尚义带队开始了「超越摩尔计划」。传统互联技术下,传输速率已经触及天花板。蒋尚义开始尝试一种新思路:把两颗芯片放到一起封装,物理距离缩短了,传输速度自然提高。为了区别于传统封装,蒋尚义将其命名为「先进封装」。2011 年,台积电得到 FPGA 大厂赛灵思订单,凭借 CoWoS 以及共同开发的硅通孔(TSV)等技术,成功将 4 个 28nm FPGA 芯片拼接在一起,推出了史上最大的 FPGA 芯片。然而,大部分客户对 CoWoS 兴致寥寥,赛灵思的订单杯水车薪。老客户高通的高管在与蒋尚义共进午餐时直白表示,CoWoS 技术很好,但「我只愿意为它花费 1 美分/平方毫米」,而台积电当时的售价是 7 美分/平方毫米。据说英伟达也是台积电 CoWoS 的第一批目标客户之一,因为数据传输的瓶颈一直是困扰 GPU 计算的核心问题。但听到台积电的报价后,英伟达当场表示,老技术还能再凑合几年。另一方面,先进制程还在稳步推进,先进封装的理念显得过于超前,毕竟领导还在开卡罗拉,你就别急着换宝马了。因此,先进封装团队在台积电内部的一度边缘化,甚至被当做老干部疗养院。后来跳槽三星的梁孟松,就认为自己被调往先进封装业务属于「下放」。随后,台积电开始给 CoWoS 做减法,掏出了替代方案「InFO」,将昂贵的硅中介层换成其他材料,牺牲了连接密度,但成本大幅下降。紧接着,台积电遇到了可以靠一己之力改变供应商命运的超级甲方:苹果。2013 年前后,由于与三星在手机市场的竞争,苹果开始将芯片代工交由台积电。凭借 InFO 方案,台积电在 16nm 工艺的基础上,制造出了比三星 14nm 性能更强的 A10 处理器,贡献了历代 iPhone 中第二轻薄的 iPhone 7。有了苹果的大单的,台积电的先进封装业务迅速盘活,并在 2022 年拿出了震惊业界的 M1 Ultra 芯片。2024 年开年,这个攻坚十多年的「胶水大法」,又被用在了英伟达的新核弹 B200 上。英伟达顺势拿下冠名权,将这项技术命名为「NV-HBI」。先进封装方案依然昂贵,但对今天的英伟达来说,成本两个字怎么写,他们可能已经忘了。尾声
除了 CoWoS,另一个被生成式 AI 带火的技术 HBM,其探索同样可以追溯到十年前。CoWoS 拿到赛灵思的第一笔订单时,蒋尚义大喜过望,但赛灵思的动机却让他有些哭笑不得:把四个老芯片拼在一起,直接当成新产品加价卖,就不用自己开发新产品了。在美国计算机历史博物馆的采访中,蒋尚义回忆道:「我开发技术的初衷是解决性能瓶颈问题,在我看来,我的创新并没有被用在好的地方」。科技革命很难推动技术创新,反而是技术创新让科技革命成为可能。创造历史的人,永远无法预见自己在历史进程中的坐标。在我们不曾踏足的物理学的边境,还有无数伟大的创新尚在不为人知的角落。
GTX 590 显卡里有两颗 GPU 芯片
M1 Ultra 由两颗一模一样的 M1 Max 芯片拼接而成
GTX 590 显卡里有两颗 GPU 芯片
M1 Ultra 由两颗一模一样的 M1 Max 芯片拼接而成